新闻资讯
太赫兹成像相机在半导体制造中凭借其独特的物理特性(如穿透性、非破坏性、高分辨率等),已成为先进制程检测和质量控制的重要工具。

太赫兹成像相机
太赫兹成像技术原理与特性
太赫兹波的物理特性
- 波长范围:0.3~3THz(对应波长1mm~0.1mm),介于微波与红外光之间。
- 穿透能力:可穿透半导体制造中的常见材料(如硅、氧化物、光刻胶、聚合物封装材料等),但对金属不透明。
- 非破坏性:能量低,不会对半导体器件造成损伤,适合在线检测。
- 光谱特性:不同材料对太赫兹波的吸收和反射特性不同,可用于材料成分和结构分析。
成像原理
- 通过发射太赫兹脉冲并接收反射/透射信号,利用时域光谱(TDS)或频域分析重建物体内部结构,分辨率可达微米级(取决于波长和光学系统)。
在半导体制造中的核心应用场景
晶圆制造与缺陷检测
- 表面与亚表面缺陷检测
- 检测晶圆表面的划痕、裂纹、颗粒污染,以及亚表面(如氧化层下)的空洞或分层。例如,太赫兹波可穿透氧化层(SiO₂),识别硅基底与氧化层之间的界面缺陷。
- 薄膜厚度与成分监测
- 利用太赫兹干涉技术测量多层薄膜(如栅极氧化物、金属层间介质)的厚度,精度可达纳米级。
- 分析薄膜材料的密度和结晶度(如非晶硅与多晶硅的区分)。
光刻与刻蚀工艺监控
- 光刻胶厚度与均匀性检测:太赫兹波可穿透光刻胶,实时监测胶层厚度,确保曝光和显影工艺的一致性。
- 刻蚀深度控制:在刻蚀过程中,通过太赫兹反射信号判断刻蚀是否到达目标层(如硅通孔TSV的刻蚀终点检测)。
封装与互连检测
- 倒装芯片(Flip Chip)与键合检测:
- 检测焊球(Solder Bump)的空洞、开裂,以及芯片与基板之间的互连质量。太赫兹可穿透底部填充胶(Underfill),识别界面分层。
- 三维封装(3D IC)内部缺陷检测:
- 对堆叠芯片(如HBM存储器)的TSV互连、层间介质进行无损检测,识别内部气泡或金属填充不完整。
- 封装材料缺陷分析:
- 检测塑料封装(如QFP、BGA)中的裂纹、湿气渗透,或陶瓷封装中的烧结缺陷。
失效分析与可靠性测试
- 热失效定位:太赫兹成像可结合热成像技术,检测器件工作时的局部过热区域(如晶体管热斑)。
- 湿气与污染物检测:太赫兹对水分子敏感,可用于检测封装内的湿气积聚或晶圆表面的有机污染物。
太赫兹成像相机欢迎咨询长春博盛量子,0431-85916189

 高光谱/多光谱成像
高光谱/多光谱成像  光路调节相关
光路调节相关  光学频率梳相关
光学频率梳相关  荧光
荧光  光学组件
光学组件  激光器|光源
激光器|光源 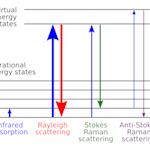 拉曼测量
拉曼测量  Libs激光诱导击穿
Libs激光诱导击穿  显微光谱测量
显微光谱测量  量子效率
量子效率